- 요약 레지스트 패턴의 해상도 및 감도를 향상시킬 수 있고 레지스트 패턴의 붕괴를 억제할 수 있는, 레지스트 화합물 및 언더레이어 화합물이 제공된다. 상기 언더레이어 화합물은 적어도 하나의 하이드록시기(hydroxyl group, -OH) 및 적어도 하나의 비닐 실릴기(vinyl silyl group)를 갖는 셀룰로오스 구조를 포함한다. 상기 레지스트 화합물은 짝음이온을 갖는 알킬화 금속산화물 나노클러스터를 포한다.
- 대표 청구항 화학식1의 구조를 포함하는 포토리소그래피용 언더레이어 화합물. [화학식1] 상기 화학식1에서, R1, R2 및 R3는 각각 독립적으로 수소 또는 중수소이거나 화학식2, 화학식3 또는 화학식4로 표시되는 작용기이고, n은 2 내지 10,000의 정수이다. [화학식2] [화학식3] [화학식4] 상기 화학식2 및 상기 화학식4에서, m은 1 내지 20의 정수이고, 상기 화학식3 및 상기 화학식4에서, R4, R5, R6, R7 및 R8은 각각 독립적으로 수소, 중수소, 또는 탄소수 1 내지 3의 알킬기이고, 상기 화학식2 내지 상기 화학식4에서, *는 상기 화학식1의 산소에 결합되는 부분이다.
-
대표 도면
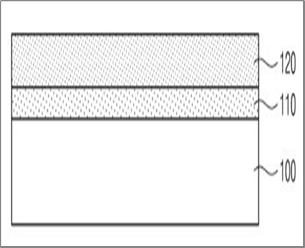
-
전략기술 분류
반도체·디스플레이
전력반도체 - 출원번호 10-2022-0186178 KIPRIS
- 출원일 2022-12-27
- 공개번호 10-2023-0161325
- 공개일 2023-11-27
- 등록번호
- 등록일
- 우선권 번호 10-2022-0060058
- 우선권 국가 KR
- 우선권 주장일 2022-05-17
- 현재 상태 심사중
- 현재 권리자
- IPC 코드 G03F-007/075, G03F-007/004, G03F-007/09, G03F-007/20, G03F-007/32, H01L-021/027



































































Copyright ⓒ 한국연구재단 기술사업화센터 (NRF-TCC) All rights reserved.

